
介紹
從自動(dòng)駕駛汽車到手術(shù)機(jī)器人,我們的智能萬(wàn)物世界正在推動(dòng)對(duì)半導(dǎo)體日益增長(zhǎng)的新需求。全球大流行帶來(lái)的前所未有的市場(chǎng)變化以及隨之而來(lái)的供應(yīng)鏈壓力凸顯了芯片短缺,而用戶期望他們的電子產(chǎn)品能夠提供越來(lái)越復(fù)雜的功能。這樣的環(huán)境為電子行業(yè)帶來(lái)了充滿希望的機(jī)會(huì),新的參與者進(jìn)入了半導(dǎo)體領(lǐng)域。然而,設(shè)計(jì)團(tuán)隊(duì)發(fā)現(xiàn),傳統(tǒng)的單片半導(dǎo)體設(shè)計(jì)不再滿足某些計(jì)算密集型、工作負(fù)載繁重的應(yīng)用程序的成本、性能或功能需求。遵循摩爾定律的路徑并遷移到較小的過(guò)程節(jié)點(diǎn)也有其局限性。
隨著摩爾定律放緩,系統(tǒng)復(fù)雜性增加,晶體管數(shù)量膨脹到數(shù)萬(wàn)億,電子行業(yè)如何繼續(xù)下去?
多芯片系統(tǒng)已成為超越摩爾定律的解決方案,解決了系統(tǒng)復(fù)雜性的挑戰(zhàn),允許加速、經(jīng)濟(jì)高效地?cái)U(kuò)展系統(tǒng)功能,降低風(fēng)險(xiǎn)和上市時(shí)間,通過(guò)提高吞吐量降低系統(tǒng)功耗,并快速創(chuàng)建新的產(chǎn)品變體。對(duì)于高性能計(jì)算 (HPC)、高度自動(dòng)化車輛、移動(dòng)和超大規(guī)模數(shù)據(jù)中心等應(yīng)用,多芯片系統(tǒng)正在成為首選的系統(tǒng)架構(gòu)。
當(dāng)然,多芯片系統(tǒng)是一種最佳的解決方案,但在軟件開(kāi)發(fā)和建模、電源和熱管理、分層測(cè)試和維修、芯片間連接、系統(tǒng)良率等領(lǐng)域并非沒(méi)有挑戰(zhàn)。如何確保您的多芯片系統(tǒng)按預(yù)期運(yùn)行?您如何高效快速地完成這一切?從設(shè)計(jì)探索一直到現(xiàn)場(chǎng)監(jiān)控,從整體系統(tǒng)的角度來(lái)看,中間需要考慮哪些關(guān)鍵步驟?
簡(jiǎn)而言之,設(shè)計(jì)多芯片系統(tǒng)與設(shè)計(jì)單片片上系統(tǒng)(SoC)完全不同。您知道的每個(gè)步驟,如分區(qū)、實(shí)現(xiàn)、驗(yàn)證、簽核和測(cè)試,都必須從系統(tǒng)角度執(zhí)行,從一個(gè)芯片到多個(gè)芯片。適用于單片 SoC 的方法可能不足以滿足這些更復(fù)雜的系統(tǒng)。
閱讀下文能更深入地了解多芯片系統(tǒng):它們的市場(chǎng)驅(qū)動(dòng)因素;如何使架構(gòu)探索、軟件開(kāi)發(fā)、系統(tǒng)驗(yàn)證、設(shè)計(jì)實(shí)施以及制造和可靠性等關(guān)鍵步驟適應(yīng)系統(tǒng);以及持續(xù)半導(dǎo)體創(chuàng)新的機(jī)會(huì)。
什么是多芯片系統(tǒng)?
首先,讓我們準(zhǔn)確定義多芯片系統(tǒng)的含義。簡(jiǎn)而言之,多芯片系統(tǒng)是一個(gè)龐大、復(fù)雜、相互依賴的系統(tǒng),由單個(gè)封裝中的多個(gè)芯片或小芯片組成。創(chuàng)建這種類型的體系結(jié)構(gòu)有不同的方法。一種方法包括分解,即將大型芯片劃分為較小的芯片,以提高與單片芯片相比的系統(tǒng)良率和成本。分解方法適用于異構(gòu)設(shè)計(jì)以及同構(gòu)設(shè)計(jì)。對(duì)于前者,一個(gè)例子是汽車系統(tǒng),該系統(tǒng)被分解為不同的芯片以實(shí)現(xiàn)不同的功能,如傳感器、物體檢測(cè)和通用計(jì)算。對(duì)于后者,一個(gè)示例是將設(shè)計(jì)分解為同一計(jì)算芯片上的多個(gè)實(shí)例。
執(zhí)行多晶片系統(tǒng)的另一種方法涉及組裝來(lái)自不同工藝技術(shù)的晶粒,以實(shí)現(xiàn)最佳的系統(tǒng)功能和性能。例如,這樣的系統(tǒng)可能包含用于數(shù)字計(jì)算、模擬、存儲(chǔ)器和光學(xué)計(jì)算的芯片,每個(gè)芯片都采用適合其目標(biāo)功能的工藝技術(shù)。通過(guò)在組合中包含經(jīng)過(guò)驗(yàn)證和已知良好的芯片,例如可重復(fù)使用的IP模塊,團(tuán)隊(duì)可以降低設(shè)計(jì)風(fēng)險(xiǎn)和工作量。無(wú)論采用哪種方法,與大型單片SoC相比,基于多個(gè)較小芯片制造設(shè)計(jì)也更具成本效益(從良率的角度來(lái)看更好)。
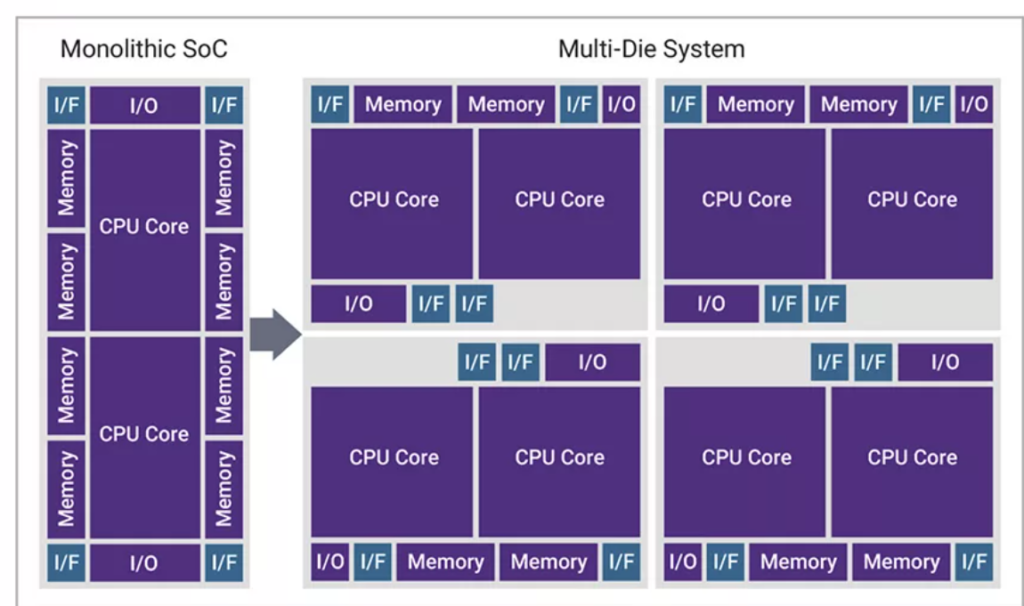
多芯片系統(tǒng)提供各種類型的封裝,無(wú)論是并排還是垂直堆疊的芯片放置。先進(jìn)封裝類型在性能、面積和連接性方面具有不同的優(yōu)勢(shì),在復(fù)雜性和組裝方面也存在差異。
硅中介層是一種硅芯片,用作電信號(hào)傳遞到另一個(gè)元件的管道。由于硅中介層為信號(hào)提供了較大的導(dǎo)管,因此縮短了系統(tǒng)IP模塊之間的距離,并最大限度地減少了寄生延遲。由于采用RDL架構(gòu),再分布層(RDL)中介層允許扇出電路,并在連接到中介層的芯片之間進(jìn)行橫向通信,使其成為2.5D和3D IC集成不可或缺的元素。
與傳統(tǒng)封裝相比,扇出晶圓級(jí)封裝可實(shí)現(xiàn)更小的封裝尺寸以及更好的熱性能和電氣性能。這種 IC 封裝類型還支持更多觸點(diǎn),而不會(huì)增加芯片尺寸。混合鍵合可提供此處討論的類型中密度最高,以及功率效率。混合鍵合具有非常小的凸塊間距和用于連接的硅通孔 (TSV),允許將兩個(gè)晶圓粘合在一起,作為一個(gè)整體工作。
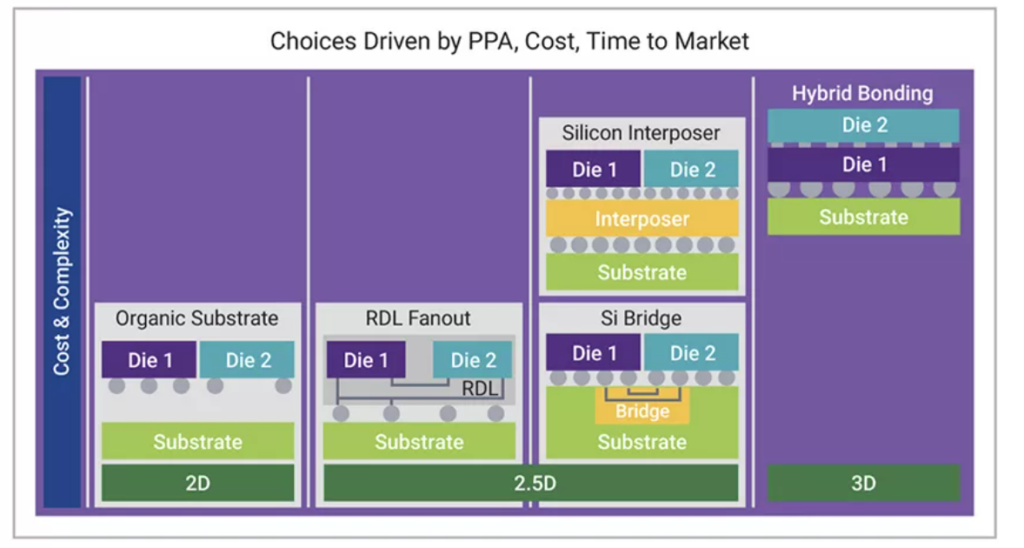
行業(yè)標(biāo)準(zhǔn)確保質(zhì)量和互操作性
半導(dǎo)體設(shè)計(jì)的歷史走上了一條更順暢的道路,這在一定程度上要?dú)w功于行業(yè)標(biāo)準(zhǔn),這些標(biāo)準(zhǔn)在確保質(zhì)量、一致性和互操作性方面發(fā)揮著關(guān)鍵作用。多芯片系統(tǒng)的兩個(gè)關(guān)鍵標(biāo)準(zhǔn)是HBM3和UCIe。HBM3 提供緊密耦合的高密度內(nèi)存,有助于緩解或消除瓶頸。UCIe可實(shí)現(xiàn)可定制的封裝級(jí)芯片集成,并適應(yīng)每個(gè)引腳32 Gbps的設(shè)計(jì),有望成為芯片到芯片互連的事實(shí)標(biāo)準(zhǔn)。
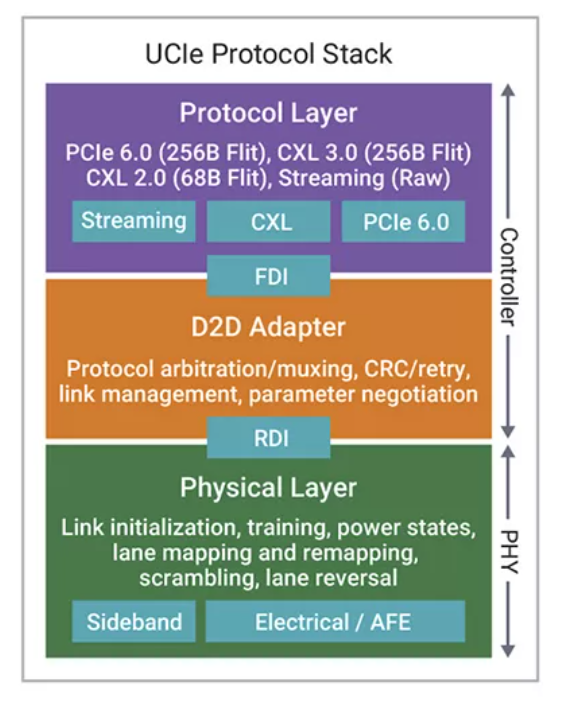
芯片間接口是實(shí)現(xiàn)多芯片系統(tǒng)不可或缺的一部分。它們由物理層 (PHY) 和控制器模塊組成,提供組裝在同一封裝中的兩個(gè)硅芯片之間的數(shù)據(jù)接口。分解芯片依賴于支持高數(shù)據(jù)速率的幾種芯片到芯片連接架構(gòu),這就是UCIe在這里脫穎而出的原因。芯片間接口的其他關(guān)鍵特性包括:
- 模塊性
- 互操作性
- 靈活性
- 高帶寬效率
- 高功率效率
- 低延遲
- 堅(jiān)固、安全的已知良好模具
- 短距離、低損耗通道,無(wú)任何明顯中斷
芯片到芯片控制器和 PHY IP 有助于確保接口的設(shè)計(jì)符合這些標(biāo)準(zhǔn)。具有錯(cuò)誤恢復(fù)機(jī)制的控制器 IP 可提供高水平的數(shù)據(jù)完整性和鏈路可靠性。PHY IP 提供高帶寬和低延遲,以支持計(jì)算密集型工作負(fù)載。UCIe 控制器和 PHY IP 支持標(biāo)準(zhǔn)和高級(jí)封裝類型以及最流行的接口,如 PCI Express (PCIe) 和 Compute Express Link (CXL) 以及用戶定義的流協(xié)議。PCIe 5.0/6.0、CXL 2.0/3.0、112G/224G 以太網(wǎng)等對(duì)于封裝以外的連接非常重要。
更多的 I/O 接口呈現(xiàn)更多的潛在攻擊面。芯片認(rèn)證、芯片間接口加密和調(diào)試是解決多芯片設(shè)計(jì)中安全風(fēng)險(xiǎn)的一些方法。包括UCIe在內(nèi)的各種標(biāo)準(zhǔn)組織正在進(jìn)行標(biāo)準(zhǔn)化計(jì)劃,以調(diào)整這些系統(tǒng)的安全性。
正如本文后面將討論的那樣,應(yīng)用協(xié)同優(yōu)化方法同時(shí)處理系統(tǒng)、芯片和封裝有助于優(yōu)化性能和功耗。
為什么需要多晶片系統(tǒng)?
現(xiàn)在,究竟是什么推動(dòng)了對(duì)多芯片設(shè)計(jì)的需求?我們正處于系統(tǒng)摩爾時(shí)代,這是一個(gè)系統(tǒng)性和規(guī)模復(fù)雜性不斷上升的時(shí)代,正在推動(dòng)摩爾定律的極限。對(duì)人工智能、智能和聯(lián)網(wǎng)汽車以及物聯(lián)網(wǎng)等智能萬(wàn)物應(yīng)用的更大需求正在擾亂市場(chǎng)動(dòng)態(tài),并改變我們必須推動(dòng)創(chuàng)新的方式。數(shù)據(jù)中心等豐富的數(shù)據(jù)應(yīng)用程序管理著不斷增長(zhǎng)的數(shù)據(jù)量(在許多情況下,相當(dāng)于PB級(jí))。同時(shí),隨著帶寬饑渴的機(jī)器對(duì)機(jī)器通信的出現(xiàn),數(shù)據(jù)本身變得更加復(fù)雜。
今天的SoC已經(jīng)變得相當(dāng)大,以支持這些計(jì)算密集型應(yīng)用,擁有數(shù)萬(wàn)億個(gè)晶體管和類似于郵票的大小。隨著芯片尺寸達(dá)到制造設(shè)備的光罩極限,增加更多晶體管以支持應(yīng)用需求需要增加更多芯片。問(wèn)題是,要提高產(chǎn)量以實(shí)現(xiàn)所需的產(chǎn)量,需要一條陡峭的學(xué)習(xí)曲線。將SoC拆分為更小的芯片可解決學(xué)習(xí)曲線和良率問(wèn)題。通過(guò)在多芯片系統(tǒng)中重復(fù)使用經(jīng)過(guò)硅驗(yàn)證的芯片,團(tuán)隊(duì)可以加快系統(tǒng)上市時(shí)間。
然而,隨著封裝中芯片的增加,成本節(jié)約從硅轉(zhuǎn)移到封裝,因此封裝成本變得很大。盡管如此,在四個(gè)關(guān)鍵驅(qū)動(dòng)因素的融合推動(dòng)下,邁向多芯片系統(tǒng)的步伐仍在繼續(xù):
- 成本,因?yàn)殡S著時(shí)間的推移,實(shí)現(xiàn)解決SysMoore復(fù)雜性的芯片類型的產(chǎn)量已經(jīng)變得非常昂貴
- 不斷增長(zhǎng)的功能,需要更高的帶寬、更低的延遲,以及面對(duì)光罩極限挑戰(zhàn)時(shí)更高的計(jì)算性能
- 功耗困境,可以通過(guò)拆分大型設(shè)計(jì)來(lái)更好地解決
- 多個(gè)終端市場(chǎng)機(jī)會(huì)的需求,這就產(chǎn)生了對(duì)最佳模塊化架構(gòu)的需求
傳統(tǒng)芯片制造商并不是唯一進(jìn)入多芯片系統(tǒng)領(lǐng)域的公司。擁有龐大數(shù)據(jù)中心的超大規(guī)模企業(yè)、開(kāi)發(fā)自主功能的汽車制造商和網(wǎng)絡(luò)公司都在設(shè)計(jì)自己的芯片,并在許多方面推動(dòng)向多芯片系統(tǒng)架構(gòu)的轉(zhuǎn)變,以支持其計(jì)算密集型應(yīng)用。這些系統(tǒng)公司本質(zhì)上是在努力構(gòu)建優(yōu)化的架構(gòu),以實(shí)現(xiàn)差異化,以滿足自己獨(dú)特的市場(chǎng)需求,換句話說(shuō),特定領(lǐng)域的設(shè)計(jì)。例如,他們可能對(duì)性能、安全性、安全性或可靠性有特殊要求,而多芯片系統(tǒng)設(shè)計(jì)可以幫助他們實(shí)現(xiàn)這些要求。但是,這確實(shí)需要對(duì)芯片、軟件和封裝有深入的了解。
需要全面的設(shè)計(jì)方法
超大規(guī)模企業(yè)和垂直行業(yè)對(duì)硅芯片提出了很高的要求,以支持其特定領(lǐng)域的需求,許多企業(yè)擁有硅設(shè)計(jì)所需的雄厚資金。毫不奇怪,其中許多公司正在設(shè)計(jì)自己的芯片并轉(zhuǎn)向多芯片系統(tǒng),以滿足這些細(xì)分市場(chǎng)所需的計(jì)算密度要求。有些可能需要專門的架構(gòu)來(lái)優(yōu)化深度學(xué)習(xí)算法的性能。對(duì)于其他人來(lái)說(shuō),它可能是一個(gè)在移動(dòng)消費(fèi)設(shè)備或汽車子系統(tǒng)的功耗和性能之間取得適當(dāng)平衡的系統(tǒng)。例如,一家大型汽車制造商依賴于異構(gòu)設(shè)計(jì),其芯片被分解,以實(shí)現(xiàn)與傳感器輸入以及物體檢測(cè)和通用計(jì)算相關(guān)的功能。另一個(gè)例子是,光學(xué)計(jì)算領(lǐng)域的一個(gè)主要參與者將數(shù)字計(jì)算、模擬、存儲(chǔ)器和光學(xué)計(jì)算的不同工藝技術(shù)集成到其系統(tǒng)中。可以說(shuō),半導(dǎo)體領(lǐng)域正在經(jīng)歷巨大的變化。
在設(shè)計(jì)或采購(gòu)單個(gè)模具時(shí),重要的是要考慮封裝、互連和整個(gè)系統(tǒng)。模具應(yīng)該如何分割?邏輯組件應(yīng)該放在存儲(chǔ)器上,反之亦然?哪種包裝最適合最終應(yīng)用?每個(gè)選擇和決策都應(yīng)考慮到每個(gè)部分,以及每個(gè)部分將如何影響設(shè)計(jì)的整體 PPA 目標(biāo)。

在 2D 世界中,通常的做法是,一個(gè)團(tuán)隊(duì)處理他們的部分并將結(jié)果交給下一個(gè)團(tuán)隊(duì)。通過(guò)多芯片系統(tǒng)設(shè)計(jì),理想情況下,所有團(tuán)隊(duì)都應(yīng)共同應(yīng)對(duì)挑戰(zhàn)。功耗、信號(hào)完整性、鄰近效應(yīng)和散熱等重要參數(shù)無(wú)法再獨(dú)立分析,因?yàn)橐粋€(gè)區(qū)域會(huì)影響另一個(gè)區(qū)域。前端邏輯設(shè)計(jì)必須考慮后端物理設(shè)計(jì)。否則,可能會(huì)導(dǎo)致前端和后端設(shè)計(jì)之間的耗時(shí)迭代,從而影響上市時(shí)間和總體設(shè)計(jì)成本。
在這種新的設(shè)計(jì)環(huán)境中,EDA公司必須提高自己的水平,介入幫助客戶完成從系統(tǒng)規(guī)劃到實(shí)施和固件/硬件/軟件共同開(kāi)發(fā)的所有工作。用于設(shè)計(jì)和驗(yàn)證、原型設(shè)計(jì)、IP 集成、測(cè)試和芯片生命周期管理的傳統(tǒng)流程和方法已不足以支持多芯片設(shè)計(jì),也無(wú)法有效地將不同的點(diǎn)工具拼接在一起。多芯片系統(tǒng)的本質(zhì)是多維的,因此市場(chǎng)需要一個(gè)可擴(kuò)展、有凝聚力和全面的解決方案,以處理這些設(shè)計(jì)的復(fù)雜性,提高生產(chǎn)力以滿足上市時(shí)間目標(biāo),并實(shí)現(xiàn) PPA 優(yōu)化。
架構(gòu)探索:探索、優(yōu)化、融合
設(shè)計(jì)起點(diǎn),即架構(gòu)探索,必須采用分析驅(qū)動(dòng)的方法,考慮宏觀架構(gòu)決策,如IP選擇、硬件/軟件分區(qū)、系統(tǒng)級(jí)功耗分析和互連/存儲(chǔ)器尺寸。此外,還有與聚合(從芯片組裝系統(tǒng))和解聚合(將應(yīng)用程序分區(qū)到多個(gè)芯片)相關(guān)的多芯片宏架構(gòu)決策。
若要了解在此階段必須回答的問(wèn)題,請(qǐng)考慮一個(gè)復(fù)雜的應(yīng)用程序,如超大規(guī)模數(shù)據(jù)中心。每種類型需要多少個(gè)模具,它們應(yīng)該在哪些工藝節(jié)點(diǎn)上,以及如何連接它們?對(duì)于每個(gè)芯片,如何將不同子系統(tǒng)的功能劃分為本地處理元素?具有不同存儲(chǔ)器和計(jì)算芯片的系統(tǒng)將如何組裝?即使您已確保芯片設(shè)計(jì)正確,您如何確保整個(gè)系統(tǒng)在組裝后將滿足您的功率和性能目標(biāo)?分析驅(qū)動(dòng)的方法將允許您盡早迭代您的許多選擇,以優(yōu)化您的多芯片系統(tǒng)和成本。
對(duì)于汽車等安全關(guān)鍵型應(yīng)用,可預(yù)測(cè)性是一個(gè)重要標(biāo)準(zhǔn)。最終,利用建模、分析、模擬和實(shí)驗(yàn)的數(shù)據(jù)驅(qū)動(dòng)型架構(gòu)規(guī)范方法將指導(dǎo)方向。
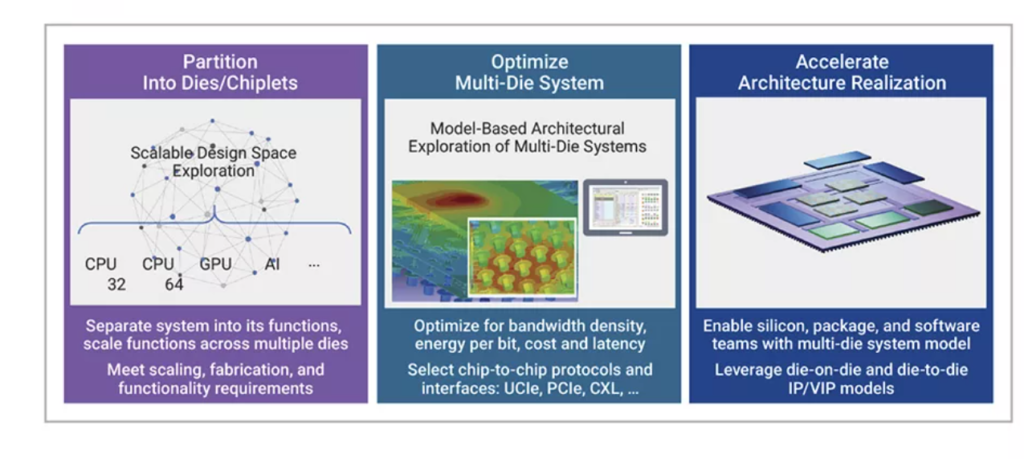
幾個(gè)關(guān)鍵領(lǐng)域的早期架構(gòu)決策可以增強(qiáng)設(shè)計(jì)過(guò)程:
- 多芯片系統(tǒng)劃分為芯片,以優(yōu)化芯片到芯片的流量
- 確保有效吞吐量和延遲的芯片到芯片通信注意事項(xiàng)
- 在接口功耗、吞吐量和芯片布局之間進(jìn)行權(quán)衡
- 不同制造和封裝技術(shù)對(duì)性能的影響
- 芯片到芯片協(xié)議和接口
除了做出這些早期架構(gòu)決策外,工程團(tuán)隊(duì)還必須解決芯片到芯片的性能瓶頸。基于分區(qū)和芯片到芯片接口選擇對(duì)延遲和性能進(jìn)行建模可以在這方面有所幫助。最后,另一個(gè)重大挑戰(zhàn)是通過(guò)在一個(gè)封裝中解決系統(tǒng)功耗以及多個(gè)芯片的熱影響來(lái)滿足功耗和熱關(guān)鍵性能指標(biāo)(KPI)。
需要了解的是,當(dāng)今工具流中可用的自動(dòng)化已經(jīng)將架構(gòu)探索提升到過(guò)去幾年基于電子表格的手動(dòng)預(yù)測(cè)之外。展望未來(lái),統(tǒng)一的設(shè)計(jì)空間探索可以進(jìn)一步提高這一過(guò)程的準(zhǔn)確性和生產(chǎn)力。
確保具有堅(jiān)實(shí)熱基礎(chǔ)的穩(wěn)健系統(tǒng)
由于多芯片系統(tǒng)的目標(biāo)是在比單片系統(tǒng)小得多的尺寸內(nèi)實(shí)現(xiàn)更多的功能,因此每瓦性能是表示系統(tǒng)效率的關(guān)鍵屬性。然而,集成多個(gè)組件會(huì)帶來(lái)一些與熱應(yīng)力相關(guān)的挑戰(zhàn)。更高的晶體管密度會(huì)產(chǎn)生大量熱量。該架構(gòu)幾乎沒(méi)有散熱空間。如果熱量沒(méi)有散發(fā),如果溫度超出設(shè)備的最佳范圍,芯片功能可能會(huì)受到機(jī)械應(yīng)力或翹曲的阻礙。
多芯片系統(tǒng)中的散熱器和其他冷卻結(jié)構(gòu)可以提供幫助,盡管這些組件確實(shí)增加了設(shè)備面積和成本。在多芯片系統(tǒng)架構(gòu)中,設(shè)計(jì)電網(wǎng)以確保向系統(tǒng)的所有區(qū)域提供足夠的電力也變得更加復(fù)雜。
經(jīng)過(guò)迭代過(guò)程的精心規(guī)劃的架構(gòu)可以減輕熱應(yīng)力。根據(jù)初始架構(gòu)和物理規(guī)劃,團(tuán)隊(duì)可以分析由此產(chǎn)生的熱行為。然后,他們可以修改架構(gòu)并執(zhí)行物理規(guī)劃以改善熱行為。迭代將繼續(xù),直到滿足熱約束以及性能要求。
作為此迭代過(guò)程的一部分,前端的“假設(shè)”探索有助于避免被鎖定在分區(qū)結(jié)構(gòu)中,從功耗角度來(lái)看,這種結(jié)構(gòu)最終可能會(huì)變得次優(yōu)。系統(tǒng)架構(gòu)團(tuán)隊(duì)可以使用建模工具將芯片的各個(gè)部分抽象為模型,以便在設(shè)計(jì)鎖定到分區(qū)之前進(jìn)行性能分析和實(shí)現(xiàn)功耗權(quán)衡。通過(guò)將工作負(fù)載映射到多芯片系統(tǒng)上,設(shè)計(jì)團(tuán)隊(duì)可以確定每個(gè)處理元素和每個(gè)通信路徑的活動(dòng)。將硬件和軟件一起建模對(duì)于生成基本穩(wěn)健且散熱良好的設(shè)計(jì)也變得更加重要,因?yàn)樵O(shè)計(jì)中的每個(gè)芯片都有自己的軟件堆棧。在 RTL、合成、布局和布線以及其他設(shè)計(jì)步驟期間持續(xù)監(jiān)控也很有價(jià)值。隨著工具流的發(fā)展,熱感知能力越來(lái)越強(qiáng),這個(gè)過(guò)程將變得更加自動(dòng)化。
從散熱角度來(lái)看,在每個(gè)芯片中嵌入傳感器以持續(xù)監(jiān)控和調(diào)節(jié)健康狀況(硅生命周期管理技術(shù))提供了指示,例如,降低性能以冷卻系統(tǒng)。片內(nèi)傳感器通常用于汽車和移動(dòng)等應(yīng)用,并可能成為HPC和AI等應(yīng)用的主流實(shí)踐。
應(yīng)對(duì)多芯片系統(tǒng)實(shí)施挑戰(zhàn)
雖然多芯片系統(tǒng)可以應(yīng)對(duì)日益增加的系統(tǒng)性和規(guī)模復(fù)雜性,但它們確實(shí)存在工程團(tuán)隊(duì)需要解決的固有設(shè)計(jì)挑戰(zhàn)。在具有數(shù)十個(gè)芯片、高集成密度(通常為每mm10,000至高達(dá)2萬(wàn)個(gè)I/O)以及3D異構(gòu)設(shè)計(jì)和混合架構(gòu)的系統(tǒng)中,這是可以預(yù)期的。一個(gè)重要的步驟是探索可擴(kuò)展性選項(xiàng)和架構(gòu),以實(shí)現(xiàn)最佳的PPA/mm3。一個(gè)重要的方法是針對(duì) PPA、物理約束和成本共同優(yōu)化整個(gè)系統(tǒng)。
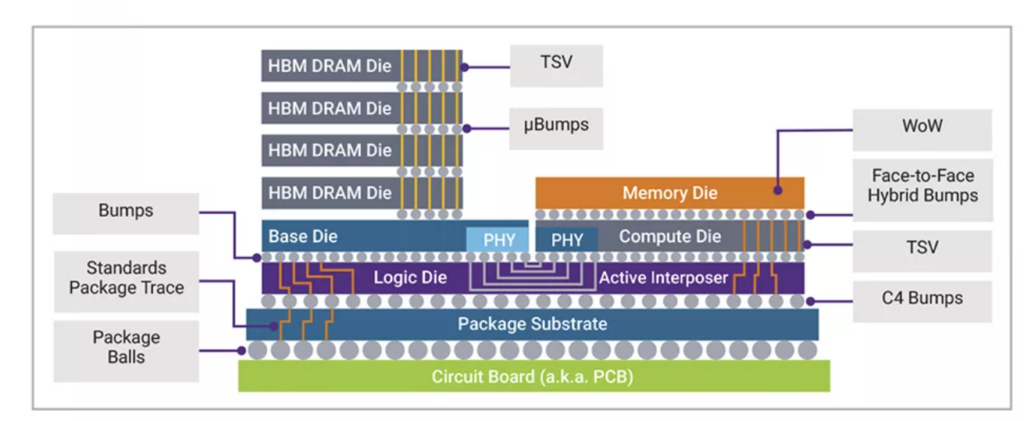
從 2D 設(shè)計(jì)到 2.5D/3D 設(shè)計(jì)的更輕松、更高效的過(guò)渡將受益于跨模具和技術(shù)的一致數(shù)據(jù)管理。這就是由單點(diǎn)解決方案組成的脫節(jié)流程可能對(duì)結(jié)果和生產(chǎn)力特別有害的地方。為了滿足多芯片系統(tǒng)的獨(dú)特要求,我們需要一種涵蓋設(shè)計(jì)、分析和簽核的芯片/封裝協(xié)同設(shè)計(jì)的統(tǒng)一方法。理想情況下,集成環(huán)境應(yīng):
- 為>100 億個(gè)晶體管連接提供集成能力和效率
- 通過(guò)設(shè)計(jì)各個(gè)階段的并行工作流程,以及具有通用技術(shù)文件和規(guī)則的通用數(shù)據(jù)模型和數(shù)據(jù)庫(kù),支持更快的設(shè)計(jì)收斂
- 通過(guò)單一軟件環(huán)境和GUI提高生產(chǎn)力,實(shí)現(xiàn)多芯片/封裝協(xié)同設(shè)計(jì)
- 在最佳 PPA 上實(shí)現(xiàn)快速收斂,同時(shí)加快封裝速度
- 盡早在系統(tǒng)范圍內(nèi)優(yōu)化設(shè)計(jì)和成本
解決多芯片系統(tǒng)軟件開(kāi)發(fā)和軟件/硬件驗(yàn)證問(wèn)題
在驗(yàn)證方面,將多芯片設(shè)計(jì)視為比SoC大得多的系統(tǒng)過(guò)于簡(jiǎn)單。確實(shí)如此,但有效地模擬非常大的系統(tǒng)會(huì)給容量帶來(lái)問(wèn)題。多晶片系統(tǒng)也往往是異構(gòu)的,晶片在不同的工藝節(jié)點(diǎn)上開(kāi)發(fā),在某些情況下,重復(fù)使用,限制了對(duì)任何專有RTL的訪問(wèn)。
對(duì)于多芯片軟件開(kāi)發(fā)和軟件/硬件驗(yàn)證,有幾個(gè)關(guān)鍵考慮因素和解決方案:
- 一個(gè)芯片的軟件啟動(dòng),軟件依賴于其他芯片。多抽象系統(tǒng)建模可以利用快速、可擴(kuò)展的執(zhí)行平臺(tái),這些平臺(tái)利用虛擬原型和硬件輔助驗(yàn)證。
- 芯片到芯片接口的驗(yàn)證。硅前驗(yàn)證可以利用使用模擬/混合信號(hào) (AMS) 流驗(yàn)證和表征的 IP 模塊。硅前驗(yàn)證和一致性測(cè)試也可以通過(guò)帶有UCIe協(xié)議接口卡的UCIe控制器IP原型進(jìn)行處理。
- 多芯片系統(tǒng)軟件/硬件驗(yàn)證。每個(gè)芯片都可以映射到自己的仿真設(shè)置上,并通過(guò)芯片到芯片事務(wù)處理器(UCIe等)連接。通過(guò)硬件輔助驗(yàn)證執(zhí)行的實(shí)際應(yīng)用工作負(fù)載可以深入了解多芯片系統(tǒng)性能,并支持電源驗(yàn)證的快速周轉(zhuǎn)時(shí)間。被測(cè)模具也可以通過(guò)速度適配器連接到成熟模具的原型。
讓我們更深入地了解這些要點(diǎn)。鑒于這樣一個(gè)運(yùn)行非常復(fù)雜軟件的復(fù)雜系統(tǒng),必須盡早開(kāi)始驗(yàn)證過(guò)程,創(chuàng)建多芯片系統(tǒng)的虛擬原型以支持軟件開(kāi)發(fā)。使用虛擬模型預(yù)先指定系統(tǒng)行為,在該模型上運(yùn)行軟件,可以使系統(tǒng)規(guī)范變得更加固化,并在仿真之前更好地定義軟件。
在多芯片系統(tǒng)中,在協(xié)議級(jí)(數(shù)字部分)和模擬級(jí)(PHY)優(yōu)化晶片間連接非常重要。AMS 仿真有助于降低硅后出現(xiàn)問(wèn)題的風(fēng)險(xiǎn)。
異構(gòu)設(shè)置有助于多芯片系統(tǒng)的驗(yàn)證。考慮一個(gè)設(shè)計(jì),由一個(gè)半導(dǎo)體供應(yīng)商開(kāi)發(fā)的三個(gè)芯片組成,該供應(yīng)商提供RTL,第四個(gè)芯片來(lái)自另一個(gè)供應(yīng)商,沒(méi)有RTL接入,但有一個(gè)現(xiàn)有的芯片。具有RTL的三個(gè)芯片可以在大規(guī)模設(shè)置中仿真,UCIe事務(wù)處理器提供不同仿真器之間的橋梁,實(shí)際上代表了實(shí)際多芯片系統(tǒng)中的連接性。第四個(gè)芯片可以封裝在測(cè)試板上的測(cè)試芯片中,該測(cè)試板通過(guò)UCIe速度適配器連接到仿真器。解決容量問(wèn)題后,仿真可以支持調(diào)試和驗(yàn)證設(shè)計(jì)軟件及其硬件。通過(guò)此過(guò)程,團(tuán)隊(duì)可以獲得做出正確決策所需的指導(dǎo)。例如,通過(guò)盡早確定系統(tǒng)中每個(gè)芯片的功耗,團(tuán)隊(duì)可以根據(jù)每個(gè)芯片的功率預(yù)算確定芯片堆疊是否可行。
驗(yàn)證多芯片系統(tǒng)的功能正確性
無(wú)論我們談?wù)摰氖菃尉€是多晶片,都必須對(duì)整個(gè)系統(tǒng)進(jìn)行驗(yàn)證,以確保其功能正確符合其設(shè)計(jì)規(guī)范。換句話說(shuō),設(shè)計(jì)是否達(dá)到了它的目的?單個(gè)模具在組裝在一起之前經(jīng)過(guò)驗(yàn)證。在芯片級(jí)別進(jìn)行更詳盡的驗(yàn)證可減少多芯片系統(tǒng)錯(cuò)誤的機(jī)會(huì)。但是,組裝后,必須在連接級(jí)別執(zhí)行測(cè)試,以確保通過(guò)一個(gè)端口推送的數(shù)據(jù)落在正確的位置,并在系統(tǒng)級(jí)別執(zhí)行測(cè)試,以確保適當(dāng)?shù)南到y(tǒng)性能。
隨著 EDA 供應(yīng)商不斷增強(qiáng)工具流程,設(shè)計(jì)界可以在解決多芯片系統(tǒng)驗(yàn)證挑戰(zhàn)的領(lǐng)域?qū)で笸顿Y。例如,利用云彈性的基于云的混合仿真可以解決容量問(wèn)題。事務(wù)級(jí)捕獲僅從分布式節(jié)點(diǎn)在云上快速流式傳輸相關(guān)數(shù)據(jù),以便稍后一起分析,可以使大型系統(tǒng)的調(diào)試易于管理。分布式仿真技術(shù)將云中的多個(gè)節(jié)點(diǎn)重新用于網(wǎng)絡(luò)中的1,000個(gè)內(nèi)核進(jìn)行并行仿真,可以加速多芯片系統(tǒng)驗(yàn)證。
加速系統(tǒng)簽核,實(shí)現(xiàn)芯片成功
設(shè)計(jì)簽核是一個(gè)多步驟的過(guò)程,涉及通過(guò)一系列迭代的檢查和測(cè)試,以確保設(shè)計(jì)在流片之前沒(méi)有缺陷。簽核檢查非常復(fù)雜,涵蓋壓降分析、信號(hào)完整性分析、靜態(tài)時(shí)序分析、電遷移和設(shè)計(jì)規(guī)則檢查等領(lǐng)域。多芯片系統(tǒng)簽核遵循類似的方法,但考慮到所有系統(tǒng)的相互依賴性,其規(guī)模要大得多。
高效、全面的提取流程可以對(duì)各種多芯片系統(tǒng)架構(gòu)進(jìn)行建模,以獲得準(zhǔn)確的性能和硅結(jié)果,從而支持先進(jìn)的工藝技術(shù)。多芯片系統(tǒng)的工程變更單 (ECO) 需要快速執(zhí)行,并與所有相關(guān)的生態(tài)系統(tǒng)合作伙伴協(xié)同執(zhí)行,以便快速識(shí)別變更并有效地協(xié)調(diào)設(shè)計(jì)。這只能通過(guò)黃金簽核工具來(lái)完成,這些工具提供全面和分層的ECO,也可以加速PPA關(guān)閉。此外,能夠準(zhǔn)確分析您的多芯片系統(tǒng)設(shè)計(jì)有助于在流片之前發(fā)現(xiàn)問(wèn)題。黃金簽核工具可以保證多芯片系統(tǒng)中的每個(gè)參數(shù)都可以準(zhǔn)確、完整和方便地閉合
測(cè)試,測(cè)試:查明已知良好模具的可用性
為了確保多芯片系統(tǒng)的質(zhì)量,需要進(jìn)行徹底的預(yù)組裝測(cè)試,以獲得芯片級(jí)別的已知良好芯片(KGD),以及互連和系統(tǒng)級(jí)別的粘合后測(cè)試。多芯片系統(tǒng)的單個(gè)芯片都經(jīng)過(guò)全面測(cè)試,以滿足最低的測(cè)試逃逸要求,如DPPM(百萬(wàn)分之缺陷部件)測(cè)量。這需要內(nèi)置于設(shè)計(jì)模塊中的高級(jí)可測(cè)試設(shè)計(jì) (DFT) 功能。例如,邏輯和存儲(chǔ)器內(nèi)置測(cè)試(BIST)需要將硬件引擎集成到設(shè)計(jì)中,以應(yīng)用測(cè)試并執(zhí)行維修,然后進(jìn)行診斷。存儲(chǔ)器(以及互連,就此而言)中的冗余允許在維修期間優(yōu)化良率。
當(dāng)需要在晶圓級(jí)別測(cè)試芯片時(shí),團(tuán)隊(duì)可能會(huì)發(fā)現(xiàn)有許多凸塊可能太小且太密集而無(wú)法物理探測(cè),因此可能需要專用焊盤用于預(yù)組裝階段基于晶圓的測(cè)試。這些是犧牲墊,不會(huì)粘合到最終設(shè)計(jì)中。在對(duì)單個(gè)模具進(jìn)行徹底測(cè)試和修復(fù)后,它可以移動(dòng)到芯片到模具空間進(jìn)行組裝和粘合。一旦存儲(chǔ)器和邏輯芯片部分或完全綁定,測(cè)試互連有助于確定芯片到芯片的連接是否良好或是否需要維修。所有互連器件在組裝后都要經(jīng)過(guò)這樣的測(cè)試、維修和重新測(cè)試過(guò)程。最后一步是測(cè)試多芯片堆棧和封裝,以評(píng)估芯片是否仍可完全運(yùn)行并修復(fù),以防它們?cè)谶\(yùn)輸、安裝或組裝過(guò)程中損壞。
特別是對(duì)于多芯片系統(tǒng),IEEE Std 1838-2019 是多芯片測(cè)試訪問(wèn)的強(qiáng)制性和可選片上硬件組件的標(biāo)準(zhǔn)尋址,允許對(duì)芯片和相鄰芯片之間的互連層進(jìn)行單獨(dú)測(cè)試。根據(jù)IEEE的說(shuō)法,該標(biāo)準(zhǔn)主要適用于TSV,但也可以涵蓋其他2.5D互連技術(shù),包括引線鍵合。3DIC 帶來(lái)了獨(dú)特的測(cè)試挑戰(zhàn),并且需要從堆棧級(jí)別的鍵合焊盤訪問(wèn)每個(gè)芯片的嵌入式測(cè)試儀器的機(jī)制。
傳統(tǒng)上,DFT團(tuán)隊(duì)使用從板級(jí)繼承的測(cè)試訪問(wèn)機(jī)制(例如邊界掃描)來(lái)模擬芯片到芯片互連并執(zhí)行其測(cè)試生成。這種方法是相當(dāng)手動(dòng)的,因?yàn)閳F(tuán)隊(duì)必須提取網(wǎng)表,自己構(gòu)建所有內(nèi)容,并創(chuàng)建驗(yàn)證環(huán)境。為了在測(cè)試階段提高生產(chǎn)率,需要自動(dòng)化的晶粒到晶粒測(cè)試解決方案。
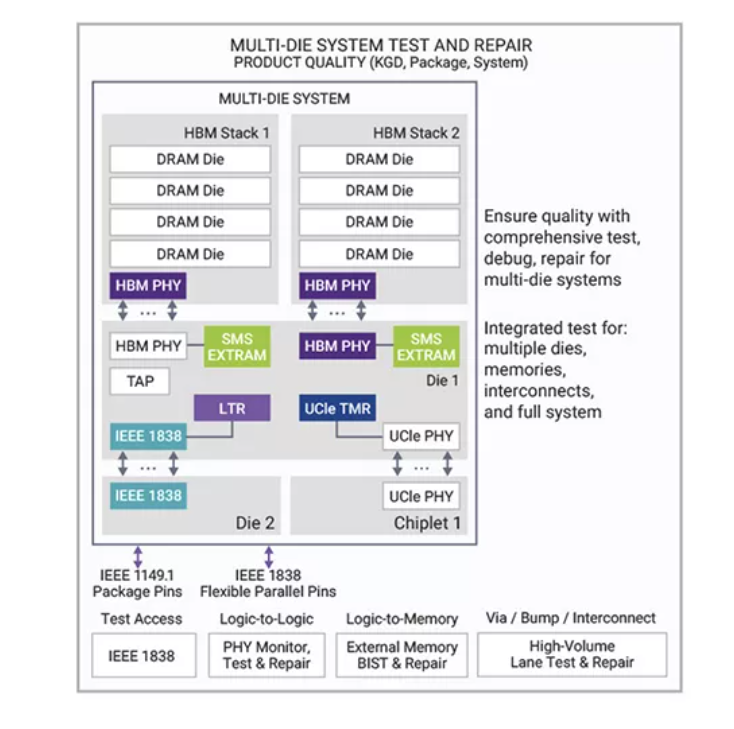
芯片生命周期管理如何影響系統(tǒng)運(yùn)行
硅健康也可以通過(guò)硅生命周期管理(SLM)技術(shù)進(jìn)行評(píng)估。SLM 涉及將監(jiān)視器集成到設(shè)計(jì)的組件中,以在設(shè)備的整個(gè)生命周期中提取數(shù)據(jù),即使在現(xiàn)場(chǎng)也是如此。從芯片到系統(tǒng)收集的深入、可操作的見(jiàn)解允許持續(xù)分析和優(yōu)化。
對(duì)于多芯片系統(tǒng),監(jiān)控基礎(chǔ)設(shè)施應(yīng)統(tǒng)一在多個(gè)芯片之間。這個(gè)想法是捕獲芯片整個(gè)生命周期中的環(huán)境、結(jié)構(gòu)和功能條件的概況。挑戰(zhàn)在于復(fù)雜性驅(qū)動(dòng)的可靠性、電源管理和互連問(wèn)題。
例如,考慮到系統(tǒng)的相互依賴性,設(shè)計(jì)團(tuán)隊(duì)需要知道在哪里放置兩個(gè)具有非常不同熱特性的芯片,以便一個(gè)芯片的散熱不會(huì)對(duì)另一個(gè)芯片或系統(tǒng)的運(yùn)行產(chǎn)生負(fù)面影響。一旦進(jìn)入現(xiàn)場(chǎng),芯片就會(huì)受到老化和溫度的影響,因此連續(xù)監(jiān)測(cè)是一項(xiàng)有價(jià)值的功能。在分解的世界中,一旦單個(gè)模具被包裝,獲得它們也更具挑戰(zhàn)性。例如,如果模具垂直堆疊,則需要一種有效的方法來(lái)訪問(wèn)它們以進(jìn)行現(xiàn)場(chǎng)表征。

EDA 工作負(fù)載云的出現(xiàn)為預(yù)測(cè)分析增添了優(yōu)勢(shì)。例如,能夠預(yù)測(cè)現(xiàn)場(chǎng)芯片退化或故障可以觸發(fā)糾正措施以防止這些結(jié)果。
在高級(jí)節(jié)點(diǎn)上設(shè)計(jì)的芯片通常具有片上監(jiān)視器,但對(duì)于舊工藝上的芯片,情況并非總是如此。此外,并非所有供應(yīng)商都向其客戶提供對(duì)此數(shù)據(jù)的訪問(wèn)權(quán)限。當(dāng)使用來(lái)自多個(gè)來(lái)源和多個(gè)技術(shù)節(jié)點(diǎn)的芯片時(shí),設(shè)計(jì)團(tuán)隊(duì)需要確定其最佳成本和覆蓋范圍權(quán)衡,以測(cè)試其復(fù)雜模塊。在多源模具模塊中整合可追溯性和分析機(jī)制有助于降低成本、質(zhì)量和可靠性。目前還沒(méi)有關(guān)于如何監(jiān)控和共享數(shù)據(jù)的標(biāo)準(zhǔn)化方法,但半導(dǎo)體行業(yè)的供應(yīng)商正在推動(dòng)這一點(diǎn)。
異構(gòu)模具集成的綜合方法
多芯片系統(tǒng)的大規(guī)模和范圍要求在深入了解這些設(shè)計(jì)中的所有相互依賴關(guān)系的基礎(chǔ)上開(kāi)發(fā)經(jīng)過(guò)驗(yàn)證、統(tǒng)一和全面的解決方案。EDA廠家能 提供業(yè)界全面、值得信賴和可擴(kuò)展的多芯片系統(tǒng)解決方案,為成功的多芯片系統(tǒng)設(shè)計(jì)提供最快的途徑。該解決方案由全面的 EDA 工具和 IP 組成,可實(shí)現(xiàn)早期架構(gòu)探索、快速軟件開(kāi)發(fā)和驗(yàn)證、高效的芯片/封裝協(xié)同設(shè)計(jì)、強(qiáng)大而安全的芯片間連接,以及改進(jìn)的運(yùn)行狀況和可靠性。經(jīng)過(guò)生產(chǎn)強(qiáng)化的設(shè)計(jì)引擎以及黃金簽核和驗(yàn)證技術(shù)可最大限度地降低風(fēng)險(xiǎn),并加快實(shí)現(xiàn)最佳系統(tǒng)的速度。
符合行業(yè)標(biāo)準(zhǔn)的廣泛高質(zhì)量 IP 產(chǎn)品組合,包括用于高帶寬、低延遲芯片間連接的 UCIe;以及防止篡改和物理攻擊的安全接口 — 還可以降低集成風(fēng)險(xiǎn),同時(shí)加快上市時(shí)間。
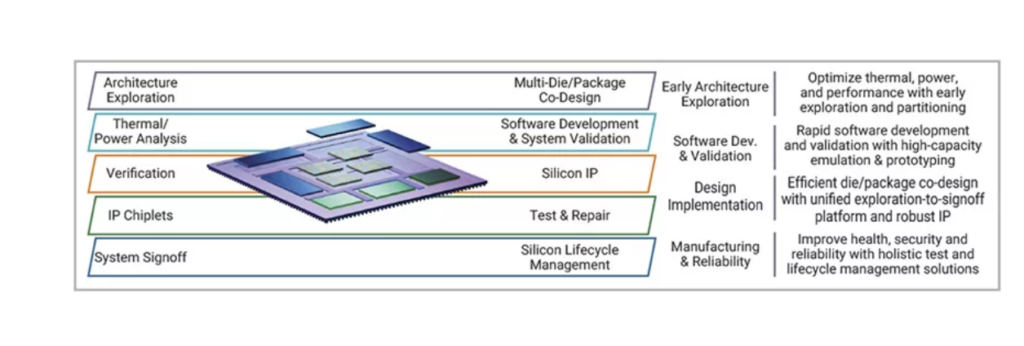
總結(jié)
隨著計(jì)算需求的增加和我們的智能萬(wàn)物世界變得更加智能,單片芯片已不足以滿足某些類型的應(yīng)用。人工智能、超大規(guī)模數(shù)據(jù)中心、網(wǎng)絡(luò)、移動(dòng)和汽車正在改變硅領(lǐng)域,將多芯片系統(tǒng)推向最前沿。與同類產(chǎn)品相比,這些分解的芯片重新聚合在單個(gè)封裝中支持巨大的性能要求,而不會(huì)對(duì)功耗、面積或良率造成影響。混合和匹配來(lái)自不同工藝技術(shù)的模具以支持不同功能的能力為設(shè)計(jì)人員提供了一種從摩爾定律中獲得更多收益的新方法。
由于多芯片系統(tǒng)是具有無(wú)數(shù)相互依賴關(guān)系的復(fù)雜系統(tǒng),因此從設(shè)計(jì)到驗(yàn)證、電源管理、測(cè)試、SLM 等,每一步都需要采用全面的方法。從系統(tǒng)角度進(jìn)行協(xié)同設(shè)計(jì)和分析有助于確保設(shè)計(jì)能夠?qū)崿F(xiàn)此架構(gòu)的 PPA 承諾。利用云和 AI 的 EDA 解決方案有助于簡(jiǎn)化設(shè)計(jì)和驗(yàn)證流程,從而獲得更好的結(jié)果。
工程師從不回避嚴(yán)峻的挑戰(zhàn)。摩爾定律將減弱,而計(jì)算和連接需求將飆升。多芯片系統(tǒng)的出現(xiàn)為電子行業(yè)繼續(xù)推動(dòng)創(chuàng)造改變我們生活的產(chǎn)品提供了前進(jìn)的方向。
在 速石,為設(shè)計(jì)人員提供了一條途徑,以經(jīng)濟(jì)實(shí)惠的價(jià)格高效交付具有前所未有的功能的創(chuàng)新產(chǎn)品。通過(guò)重復(fù)使用經(jīng)過(guò)驗(yàn)證的芯片,我們的解決方案有助于降低風(fēng)險(xiǎn),加快上市時(shí)間,并快速創(chuàng)建具有優(yōu)化系統(tǒng)功率和性能的新產(chǎn)品變體。如果您希望保持領(lǐng)先地位并從多芯片系統(tǒng)的眾多優(yōu)勢(shì)中受益,我們邀請(qǐng)您立即開(kāi)始使用我們的解決方案。加入我們,擁抱芯片設(shè)計(jì)的未來(lái),探索多芯片系統(tǒng)的可能性
本文文字轉(zhuǎn)載:https://www.synopsys.com/multi-die-system/heterogeneous-integration.html
END -
我們有個(gè)IC設(shè)計(jì)研發(fā)云平臺(tái)
IC設(shè)計(jì)全生命周期一站式覆蓋
調(diào)度器Fsched國(guó)產(chǎn)化替代、專業(yè)IT-CAD服務(wù)
100+行業(yè)客戶落地實(shí)踐
支持海內(nèi)外多地協(xié)同研發(fā)與辦公
多層安全框架層層保障
掃碼免費(fèi)試用,送200元體驗(yàn)金,入股不虧~
底部-1024x517.png)
更多EDA電子書
歡迎掃碼關(guān)注小F(ID:iamfastone)獲取

你也許想了解具體的落地場(chǎng)景:
王者帶飛LeDock!開(kāi)箱即用&一鍵定位分子庫(kù)+全流程自動(dòng)化,3.5小時(shí)完成20萬(wàn)分子對(duì)接
這樣跑COMSOL,是不是就可以發(fā)Nature了
Auto-Scale這支仙女棒如何大幅提升Virtuoso仿真效率?
1分鐘告訴你用MOE模擬200000個(gè)分子要花多少錢
LS-DYNA求解效率深度測(cè)評(píng) │ 六種規(guī)模,本地VS云端5種不同硬件配置
揭秘20000個(gè)VCS任務(wù)背后的“搬桌子”系列故事
155個(gè)GPU!多云場(chǎng)景下的Amber自由能計(jì)算
怎么把需要45天的突發(fā)性Fluent仿真計(jì)算縮短到4天之內(nèi)?
5000核大規(guī)模OPC上云,效率提升53倍
提速2920倍!用AutoDock Vina對(duì)接2800萬(wàn)個(gè)分子
從4天到1.75小時(shí),如何讓Bladed仿真效率提升55倍?
從30天到17小時(shí),如何讓HSPICE仿真效率提升42倍?
關(guān)于為應(yīng)用定義的云平臺(tái):
最強(qiáng)省錢攻略——IC設(shè)計(jì)公司老板必讀
芯片設(shè)計(jì)五部曲之三 | 戰(zhàn)略規(guī)劃家——算法仿真
芯片設(shè)計(jì)五部曲之二 | 圖靈藝術(shù)家——數(shù)字IC
芯片設(shè)計(jì)五部曲之一 | 聲光魔法師——模擬IC
【案例】速石X騰訊云X燧原:芯片設(shè)計(jì)“存算分離”混合云實(shí)踐
【ICCAD2022】首次公開(kāi)亮相!國(guó)產(chǎn)調(diào)度器Fsched,半導(dǎo)體生態(tài)1.0,上百家行業(yè)用戶最佳實(shí)踐
解密一顆芯片設(shè)計(jì)的全生命周期算力需求
居家辦公=停工?nonono,移動(dòng)式EDA芯片設(shè)計(jì),帶你效率起飛
缺人!缺錢!趕時(shí)間!初創(chuàng)IC設(shè)計(jì)公司如何“絕地求生”?
續(xù)集來(lái)了:上回那個(gè)“吃雞”成功的IC人后來(lái)發(fā)生了什么?
一次搞懂速石科技三大產(chǎn)品:FCC、FCC-E、FCP
速石科技成三星Foundry國(guó)內(nèi)首家SAFE?云合作伙伴
EDA云平臺(tái)49問(wèn)
億萬(wàn)打工人的夢(mèng):16萬(wàn)個(gè)CPU隨你用
幫助CXO解惑上云成本的迷思,看這篇就夠了
花費(fèi)4小時(shí)5500美元,速石科技躋身全球超算TOP500








